芯片测试之X-ray测试
X射线检测技术利用高能电子与金属靶撞击产生X射线,通过穿透不同密度物质后光强度的变化形成影像,从而非破坏性地观察样品内部结构。该技术广泛应用于消费级、工业级、车规级芯片及焊接组件的检测,包括芯片封装内部结构、晶圆裂纹、粘接料空洞等异常现象的检查。X射线检测有助于提高研发效率、产品质量,减少客诉和纠纷,并用于真假芯片比对。测试遵循AS6081、IDEA-STD-1010-B、MIL-STD-883L
原理:
X-ray是利用阴极射线管产生高能量电子与金属靶撞击,在撞击过程中,因电子突然减速,其损失的动能会以X-Ray形式放出。而对于样品无法以外观方式观测的位置,利用X-Ray穿透不同密度物质后其光强度的变化,产生的对比效果可形成影像,即可显示出待测物的内部结构,进而可在不破坏待测物的情况下观察待测物内部有问题的区域
应用范围:
X-ray检测是实时非破坏性的分析项目,可以检测各类消费级、工业级、车规级的芯片及焊接类组件,主要检查芯片封装内部晶圆、键合丝、基板、粘结料、塑封料,同时可以检查晶圆裂纹、粘接料空洞、粘接料爬升高度、键合丝弧度、塑封料异物、模组内部元件倾斜及焊接、ESD损伤等各类异常现象。同时可以检测原装样品或良品与普通样品内部的一致性。
1)印刷电路板制程中可能产生的缺陷,如:对齐不良或桥接以及开路;
2)SMT焊点空洞现象检测与量测;
3)各式连接线路中可能产生的开路,短路或不正常连接的缺陷检验;
4)锡球数组封装及覆芯片封装中锡球的完整性检验;
5)密度较高的塑料材质破裂或金属材质空洞检验;
X-ray检测目的:
1)前期研发工艺改善,提高研发效率;
2)焊接类组件的焊接检查,提高产品质量;
3)为客户把控质量,提升客户信任度;
4)终端产品失效的原因检查,减少客诉,提高质量避免损失及纠纷;
5)真假芯片比对,避免损失;
测试标准: AS6081-2012 4.2.6.4.4
IDEA-STD-1010-B 11.4
MIL-STD-883L-2019 2012.11
GJB 548C-2021 方法 2012.2
测试设备:X光透视检查机 2D X-ray
测试环境:环境温度: 20~28 ℃ 相对湿度: 50~60 %RH 光照强度不小于250Lx
测试重点:检查芯片封装内部晶圆、键合丝、基板、粘结料、塑封料,同时可以检查晶圆裂纹、粘接料空洞、粘接料爬升高度、键合丝弧度、塑封料异物、模组内部元件倾斜及焊接、ESD损伤等各类异常现象。
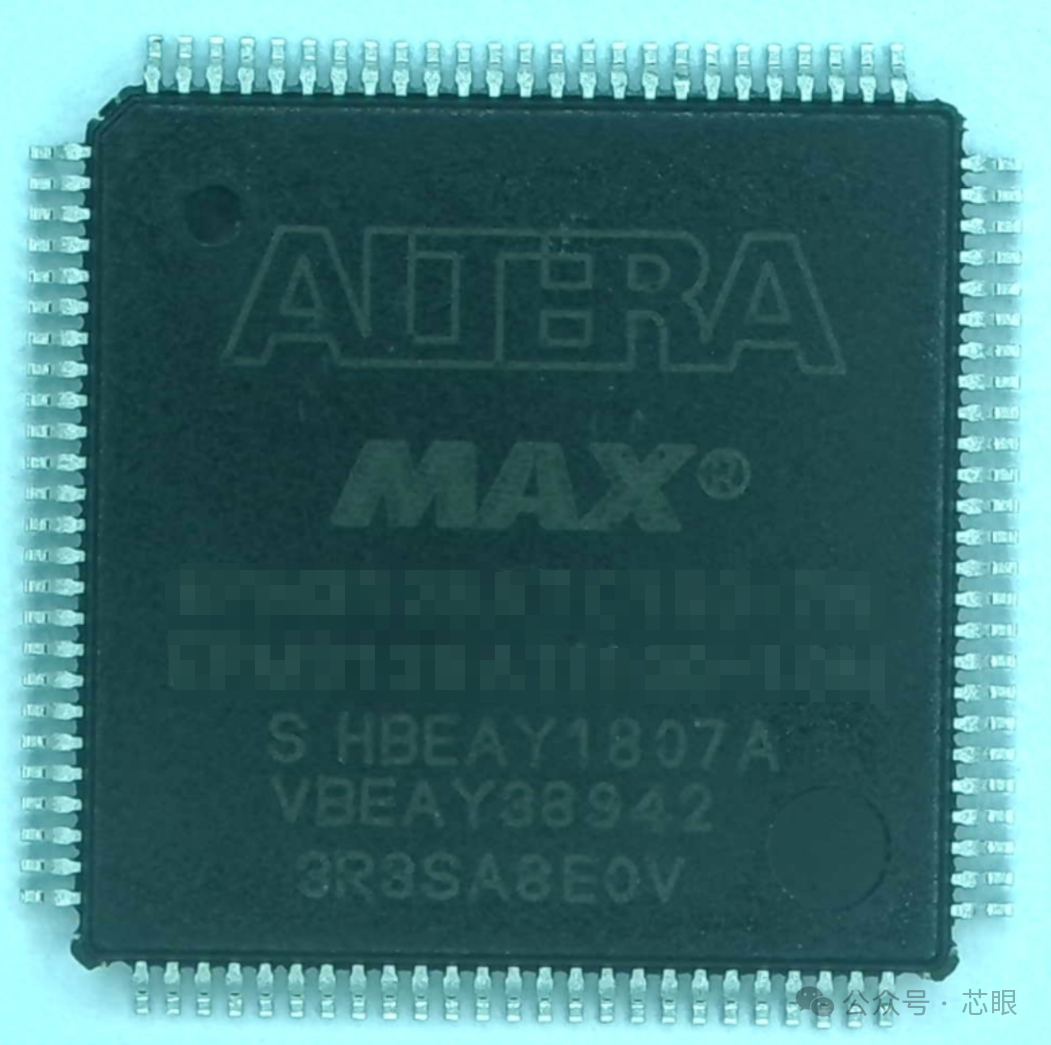
正面
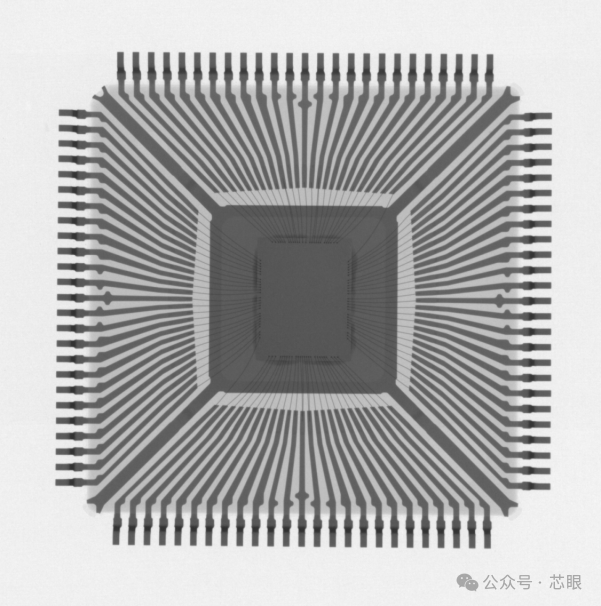
正面形貌

侧面形貌
欢迎大家交流,坚持分享半导体知识,您的关注是我持续创作高质量文章的动力!

DAMO开发者矩阵,由阿里巴巴达摩院和中国互联网协会联合发起,致力于探讨最前沿的技术趋势与应用成果,搭建高质量的交流与分享平台,推动技术创新与产业应用链接,围绕“人工智能与新型计算”构建开放共享的开发者生态。
更多推荐
 已为社区贡献5条内容
已为社区贡献5条内容








所有评论(0)