【知识分享】显微DIC应变测量:芯片半导体热学性能测量方案
XTDIC-Micro显微测量系统----光学显微镜和DIC数字图像相关技术的结合,弥补了传统设备的不足,用非接触的数字图像相关技术(DIC)获取元器件热特性参数和瞬态温度分布场来校验器件热失效过程并改善仿真模型参数。半导体器件的发热及温度的分布均匀性,对于其参量的稳定性、品质的可靠性以及器件、整片集成电路、整机和系统的寿命都有不可忽视甚至决定性的影响。上面是一个芯片热变形部分过程,并通过测试获取
·

半导体器件的发热及温度的分布均匀性,对于其参量的稳定性、品质的可靠性以及器件、整片集成电路、整机和系统的寿命都有不可忽视甚至决定性的影响。因此,在器件和系统设计中,热特性测量与分析一直是非常重要的问题。
XTDIC-Micro显微测量系统----光学显微镜和DIC数字图像相关技术的结合,弥补了传统设备的不足,用非接触的数字图像相关技术(DIC)获取元器件热特性参数和瞬态温度分布场来校验器件热失效过程并改善仿真模型参数。




上面是一个芯片热变形部分过程,并通过测试获取芯片翘曲三维曲面、翘曲截线等,使用强大的元素功能分析获取任意位置三维点、线信息。
元器件热变形测量

芯片截面的面内应变

芯片热翘曲测试

印刷电路板铜箔陶瓷板面内应变


DAMO开发者矩阵,由阿里巴巴达摩院和中国互联网协会联合发起,致力于探讨最前沿的技术趋势与应用成果,搭建高质量的交流与分享平台,推动技术创新与产业应用链接,围绕“人工智能与新型计算”构建开放共享的开发者生态。
更多推荐
 已为社区贡献7条内容
已为社区贡献7条内容

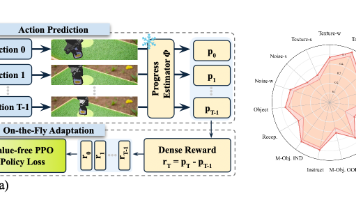





所有评论(0)