半导体与IC封装热指标:解锁芯片散热的“密码”(一)
事实上,在 JEDEC 定义的静止空气 RθJA 测量中,芯片产生的功率中有近 70% - 95% 是通过测试板散发的,而不是从封装表面散发的。例如,器件一手册的某封装的 RθJA 为 40°C/W,器件二相同封装的 RθJA 为 45°C/W,那么在实际应用中,器件一可能会比竞争对手的器件运行温度低约 10%。因此,有时定义一个 RθJA(有效)是很有用的,如果可以从系统中的热建模或测量估算出
点击阅读原文,获取更多优质内容,请关注公众号--通信射频老兵:
一、什么是RθJA和RθJMA
RθJA(Junction-to-Ambient):结到环境的热阻。
RθJMA(Junction-to-Moving Air):结到流动空气的热阻。
结到环境的热阻(RθJA)是最常报告的热指标,也是最容易被误用的指标。RθJA 是衡量特定测试板上安装的集成电路(IC)封装热性能的一种指标。RθJA 的目的是提供一个可以用来比较不同封装相对热性能的指标。
RθJA的测量按照以下步骤进行:
-
将一个器件(通常是包含热测试芯片的集成电路 [IC]封装,该芯片既能耗散功率,又能测量芯片的最高温度)安装在测试板上。
-
对测试芯片的温度感应元件进行校准。
-
将封装和测试板系统放置在静止空气(RθJA)或流动空气(RθJMA)环境中。
-
在测试芯片中耗散已知功率。
-
达到稳态后,测量结温。
-
计算测量到的环境温度与测量到的结温之间的差值,并将其除以耗散功率,得出 RθJA 的值,单位为 °C/W。
1.1、使用
不幸的是,系统设计人员常常使用 RθJA 来估算其器件在其系统中使用时的结温。通常假设用于从RθJA计算结温的方程是:

这是一种对 RθJA 热参数的误用,因为 RθJA 并非仅与封装有关,它还是许多其他系统级特性(例如器件所安装的印刷电路板 [PCB] 的设计和布局)的变量函数。实际上,测试板是一个焊接到器件引脚上的散热器。改变测试板的设计或配置会改变散热器的效率,从而改变测量到的 RθJA。事实上,在 JEDEC 定义的静止空气 RθJA 测量中,芯片产生的功率中有近 70% - 95% 是通过测试板散发的,而不是从封装表面散发的。由于实际的系统板很少能近似于用于确定 RθJA 的测试板,因此使用公式 1 应用 RθJA 会导致极其错误的数值。
表 1-1 列出了在所有材料保持不变的情况下,可能会影响给定封装外形的 RθJA 的因素。第一列列出因素,第二列则给出了关于该因素影响的大致估算规则。
表1-1. 影响给定封装外形的RθJA的因素

鉴于 RθJA 并非仅是封装本身的特性,而是封装、PCB 以及其他环境因素共同作用的结果,它最适合用于比较不同公司之间的封装热性能。例如,器件一手册的某封装的 RθJA 为 40°C/W,器件二相同封装的 RθJA 为 45°C/W,那么在实际应用中,器件一可能会比竞争对手的器件运行温度低约 10%。
1.2、测试板的影响
JEDEC 制定了一套用于测量和报告集成电路(IC)封装热性能的标准。这些标准归属于 EIA/JESD51 系列。EIAJ/Semi 也有一套热性能标准,与 JEDEC 版本存在显著差异。RθJA 并非一个常数,因此在尝试进行比较之前,确定用于计算或测量 RθJA 的标准至关重要。
在 JEDEC 规范中,允许使用两种类型的测试板。1s(单信号层)配置适用于中等密度布线的多层系统级印刷电路板(PCB)应用,能够提供典型的使用值。2s2p(双信号层、双埋地电源平面)配置则假设为低密度布线、高走线密度的板设计,并且具有埋藏的电源和地平面,能够提供最佳性能估计。图 1-1 展示了这两种测试板在 17 种不同封装类型下的 RθJA 建模差异。需要注意的是,这些模型中所有材料和封装几何形状均保持不变。

图 1-1. 不同封装类型的 1s 与 2s2p PCB 对比
如图所示,仅由于1s与2s2p测试板结构的差异,就可能导致RθJA出现高达50%的变化。
1.3、芯片尺寸的影响
封装内的芯片或芯片垫如果足够大,可以起到与散热器相同的功能。散热器的作用有两个方面。首先,它将芯片的热点处的热量扩散到封装表面更广泛的区域,从而增加对流散热。其次,它增强了从芯片垫到引脚或封装焊球的热传递,这些引脚或焊球随后将热量传导至印刷电路板(PCB)。图 1-2 展示了芯片尺寸对一种基于卷带的面阵芯片尺寸封装(CSP)的 RθJA 的影响。如图所示,这种封装的 RθJA 随芯片尺寸的变化几乎达到了 8 倍。如果计划进行芯片缩小化,重新测量或重新计算封装的 RθJA 是非常重要的。
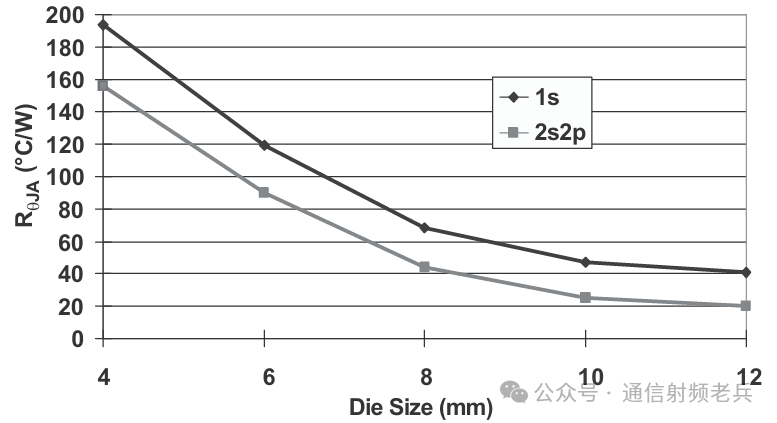
图1-2. 芯片尺寸对CSP封装的影响
1.4、封装内部几何结构配置
这一主题涉及封装内的布局,无论是传统的引线框架封装、小芯片垫(S-pad)封装、芯片上引线(LOC)封装,还是球栅阵列(BGA)封装。封装内部更普通的几何结构配置也可能对封装的热性能产生重大影响。这些配置包括封装内引线尖端与芯片垫之间的距离(如图 1-3 所示),甚至是芯片垫与引脚之间的下沉(downset)。在薄型封装中,后者是一个特别重要的热性能指标。对于 BGA 封装,中介层走线配置的设计对于将热量从芯片传导至封装焊球(进而传导至 PCB)至关重要。

图1-3. RθJA与引脚到芯片垫距离的关系
1.5、海拔
随着海拔的升高,环境空气压力会发生变化,空气的冷却效率也会随之改变。IBM 表明,与在海平面上运行的相同设备相比,设备在海拔 8000 英尺处的运行温度预计将升高 20%。其他研究者也发现,风扇性能和机箱内部气流在不同海拔下会有很大变化。这些影响因素应当被考虑在内,尤其是在系统设计从热管理角度而言处于临界状态时。许多大型系统公司都配备了压力试验箱,用于在不同有效海拔下测试其系统。通常,这些公司会在其设计中安装仪器,以测量在不同大气压力下运行时内部组件的温度。表 1-2 列出了从 IBM 的研究中得出的用于降低在海平面上确定的 RθJA 值的乘数因子。
表1-2. 乘数因子

1.6、环境温度
环境温度对对流和辐射传热有很大的影响。由于热辐射与温度的四次方(T⁴)成正比,随着温度的升高,辐射传热会显著增强。相反,随着温度升高,对流传热会受到不利影响,因为高温下空气密度较低。一般来说,辐射的影响远大于自然对流的影响。某芯片公司热实验室的实验表明,在 0°C 至 100°C 的环境温度范围内测量时,RθJA 会改善约 10% - 20%;也就是说,100°C 环境下的 RθJA 比 0°C 环境下的 RθJA 约低 20%。
1.7、功率耗散
器件表面温度推动了封装的对流和辐射能量损失。封装表面温度越高,向环境的对流和辐射散热就越高效。因此,随着封装功率耗散的增加,RθJA 会降低。对于功率耗散非常低的情况,由于表面温度升高很少,RθJA 有时会比在额定封装功率水平下高出 2 - 3 倍。
1.8、有效 RθJA
Theta-ja(RθJA)是一个系统级参数,它强烈依赖于前面各节中描述的系统参数。因此,有时定义一个 RθJA(有效)是很有用的,如果可以从系统中的热建模或测量估算出 RθJA(有效),那么在假设系统中周围组件的功率不变的情况下,就可以使用公式 1 来计算结温。此时,公式 1 变为:

在报告有效 RθJA(RθJA(effective))值时,应始终定义导致该值的系统条件。
2、RθJC:结到外壳
结到外壳的热阻(RθJC)这一指标最初是为了能够在安装散热器时估算封装的热性能而设计的。EIA/JESD51-1 指出,RθJC 是“半导体器件工作部分到封装外壳(外壳)表面(最接近芯片安装区域的表面)的热阻,当该表面被适当散热以最小化该表面的温度变化时”。尽管目前没有定义 RθJC 的 JEDEC 规范,但行业内普遍采用一种测量 RθJC 的方法。
2.1、铜(Cu)冷板 RθJC 测量法
这种方法将测试器件的几乎所有功率都通过封装的一个特定表面传导出去。根据散热器将如何应用于器件,这可能是封装的顶部或底部。通常情况下,是封装的顶部表面。RθJC 适用于确定芯片与将要安装散热器的表面之间的热阻。
总结来说,该程序如下:
-
通常包含热测试芯片的集成电路(IC)封装被安装在一块测试印刷电路板(PCB)上。这通常是一块JEDEC定义的低介电常数(low-k)1s0p(单信号层,无电源平面)PCB,其铜含量较低,以尽量减少通过PCB的热量损失。
-
当需要测量封装顶部时,封装被压装到铜冷板(一个带有循环恒温流体的铜块)上,引脚朝上,封装外壳与冷板接触;当封装的主要散热路径是通过焊接板进入PCB时,铜冷板则通过PCB与封装底部接触。
-
硅胶热膏或其他热界面材料提供冷板与封装之间的热耦合。
-
在测试样品周围提供绝缘材料,以尽量减少寄生热损失。
-
对器件施加功率。
-
测量测试芯片的结温。
-
通过压在该表面的热电偶或其他温度传感器,测量与冷板接触的封装表面的温度。
-
通过将测量到的温度差除以耗散功率,计算出RθJC。
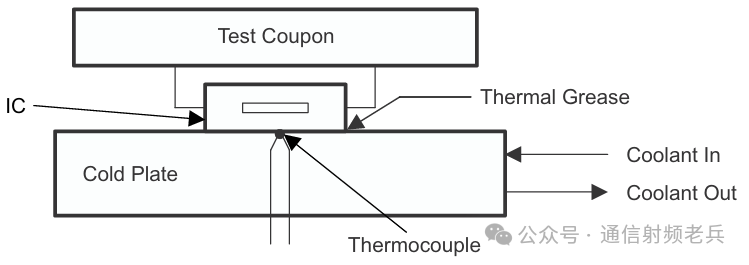
图2-1. 铜冷板测量过程
2.2、RθJC 的应用
过去对 RθJC 的过时且不准确的理解如公式 3 所示。

在这里,封装的热性能 RθJA 被报告为两个热阻之和:RθJC 和 RθCA。RθCA 表示外壳到环境的热阻,该公式定义了 RθCA。这个公式可能适用于金属外壳封装,这类封装的温度相对稳定,且与印刷电路板(PCB)没有热耦合。然而,这种条件并不适用于当今与PCB紧密耦合的塑料或陶瓷封装。现代封装中常见的大热梯度使得公式 3 的意义受到质疑。
一种传统但无效的 RθJC 使用方式是计算系统中运行芯片的结温。使用热电偶、红外相机或 Fluoroptic® 探头测量系统中运行器件的外壳温度。然后错误地使用公式 4 来计算结温:公式 4:

这里的谬误在于,在典型的塑料封装中,只有很小一部分热量是从封装的顶表面通过对流和辐射散发出去的。许多模型表明,芯片产生的热量中有 60% - 95% 是通过对流和辐射从封装所连接的印刷电路板(PCB)散发出去的。如果假设所有功率都是通过顶表面耗散的,那么通过公式 4 计算出的结温将高于实际值。在有热裕度的设计中,这只是一个麻烦,但在没有热裕度的设计中,可能会错误地施加限制。这种 RθJC 的局限性可以通过新的热指标 ΨJT 来克服,下面将对其进行描述。
公式 5 展示了在某些情况下,当一个高效率的散热器被应用于一个 RθJC 相比 RθJA 较小的器件的顶表面时,RθJC 的正确应用方式:

在这里,Rθ(SA) 表示散热器到环境的散热性能,而 Rθ(CS) 是热界面材料的外壳到散热器的热阻(见公式 7)。环境温度是指用于表征 Rθ(SA) 的位置处的温度,通常距离散热器有一定距离。这个公式对于 RθJC 相比 RθJA 较小的封装来说是最准确的,这意味着当应用足够高效的散热器时,大部分热量可以通过封装的顶表面散发出去。
公式 6 展示了一个近似公式,如果已知系统配置下的 RθJA,那么无论 RθJA、RθJC 或 Rθ(SA) 的组合如何,该公式都比公式 5 更为准确。

2.3、Rθ(CS)
如果无法直接测量 Rθ(CS) 的值,可以使用公式 7 来估算 Rθ(CS)。需要注意的是,这只是一个估算值,因为它忽略了任何两个表面之间可能形成的热界面阻抗。

其中:
T = 封装与散热器之间界面层的厚度
k = 热界面材料的本体热导率
A = 热界面材料的应用面积
2.4、RθJC(top) 和 RθJC(bot)
一些封装具有散热块或暴露的焊盘等机制,用于从封装的顶部、底部或两个表面散热。当仅使用一个表面散热时,根据 EIA/JESD51-1 规范,这个表面将用于基于 RθJC 的测量。有时,即使封装的暴露焊盘已经焊接到了印刷电路板(PCB),设计人员也可能会在封装的顶部添加散热器。在这种情况下,为了避免混淆所引用的是哪个表面,定义 RθJC(top) 和 RθJC(bot) 是合适的。封装的顶部表面是指远离 PCB 的表面,而底部表面是指面向 PCB 的表面。
当需要测量 RθJC(bot) 时,会专门制作一块带有切口的 PCB,以便封装的底部表面能够与铜冷板接触。当封装的底部表面与铜冷板接触时,封装底部表面的温度就成为用于计算外壳温度与结温之间温差的外壳温度。
需要指出的是,某些芯片器件手册有时会使用 Rθ(JP) 这一术语,即结到焊盘的热阻,来指代封装的结与暴露焊盘之间的热阻。无论焊盘是暴露在封装的顶部还是底部,都会使用这一术语。

DAMO开发者矩阵,由阿里巴巴达摩院和中国互联网协会联合发起,致力于探讨最前沿的技术趋势与应用成果,搭建高质量的交流与分享平台,推动技术创新与产业应用链接,围绕“人工智能与新型计算”构建开放共享的开发者生态。
更多推荐
 已为社区贡献4条内容
已为社区贡献4条内容







所有评论(0)