先进芯片封装初级3
依据 IC 芯片数目、封装材料、与电路板接合方式、引脚分布型态、封装形貌与内部结构等因素对 IC 元件进行分类命名。引脚插入型(PTH):引脚插入电路板的孔中,通过焊锡固定,如传统的 DIP 封装。表面黏着型(SMT):先将接脚黏贴于电路板上后再以焊接固定,包括海鸥翅型、钩型、J 型、直柄型等引脚类型。舍弃第一层级封装而直接将 IC 芯片黏结到基板上的裸晶型(Bare Chip)封装(也称为 DC
先进芯片封装初级课程(第三章)笔记

一、IC 元件的分类依据
(一)与电路板的接合方式
-
分为引脚插入型(Pin - Through - Hole,PTH,也称为插件型)与表面黏着型(Surface Mount Technology,SMT)两大类。
-

以上为PTH直插原件
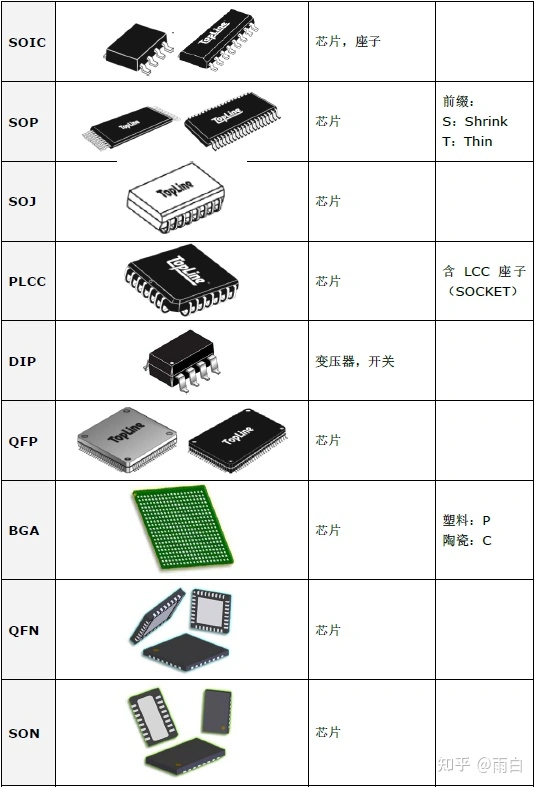
以上是一些贴片元件
(二)引脚分布型态
-
包括单边引脚、双边引脚、四边引脚、底部引脚。
(三)封装形貌与内部结构
-
有多种变形体分类,如 DIP 的其他变形体、芯片型封装(Chip Scale Packages,CSP)、DCA(Direct Chip Attach)封装、LOC(Lead on Chip)封装、PGA 封装可演变为球脚阵列封装(Ball Grid Array,BGA)等,各有其独特的结构和性能特点。
二、IC 元件标准化定义(一)
(一)分类命名依据
-
依据 IC 芯片数目、封装材料、与电路板接合方式、引脚分布型态、封装形貌与内部结构等因素对 IC 元件进行分类命名。
(二)依封装中组合的 IC 芯片数目分类
-
单晶片封装(Single Chip Packages,SCP):将单个 IC 芯片进行封装。
-
多晶片模块封装(Multi chip Module,MCM):包含多个不同功能的芯片,通过先进互连技术连接,具有高集成度、小封装尺寸、灵活性和高性能等特点,能提高信号传输速度和可靠性。
(三)依封装的材料分类
-
陶瓷封装:热传性质优良,可靠度佳,常用于高可靠度需求的 IC 封装,但脆性较高、制程温度高且成本高。
-
塑胶封装:一般以热固性材料为主,具有原料纯度高、粘度低、杂质少、低成本、易加工成型、适合自动化生产等优点,但散热性、耐热性、密封性与可靠度逊于陶瓷和金属封装。其成型方式包括转注封装(Transfer molding)和压塑封装(Compression molding),压塑封装适用于大面积封装。相同形式的 IC 用不同材料封装会有不同名称,如 DIP 元件有 PDIP(Plastic DIP)与 CERDIP(Ceramic DIP),BGA 元件有 PBGA(Plastic BGA)和 CBGA(Ceramic BGA)等。
三、IC 元件标准化定义(二)
(一)与电路板接合方式分类
-
引脚插入型(PTH):引脚插入电路板的孔中,通过焊锡固定,如传统的 DIP 封装。
-
表面黏着型(SMT):先将接脚黏贴于电路板上后再以焊接固定,包括海鸥翅型、钩型、J 型、直柄型等引脚类型。舍弃第一层级封装而直接将 IC 芯片黏结到基板上的裸晶型(Bare Chip)封装(也称为 DCA 封装)也属于 SMT 接合的一种。SMT 是一种 PCB 组装技术,根据焊接方法可分为回流焊和波峰焊,根据装配方法可分为全表面装配、单面混合装配和双面混合装配,其焊接质量受多种因素影响,如 PCB 设计、焊料质量、助焊剂质量、焊接金属表面氧化程度、印刷、安装和焊接等技术设备和管理,回流焊接质量还受焊膏质量、SMD 技术要求和回流焊接温度曲线设置等因素影响。
四、IC 元件标准化定义(三)
(一)引脚分布型态分类
-
单边引脚
-
单列式封装(Single Inline Packages,SIP):构成要素包括封装载体(如 PCB、LTCC、Silicon Submount 等)与组装工艺(如传统封装工艺 Wirebond 和 Flip Chip 及 SMT 设备)。
-
交叉引脚封装(Zig - zag Inline Packages,ZIP):具有较低的热膨胀系数和较好的机械缓冲能力,能在温度变化和机械应力下提供更稳定的封装环境;有较高的黏结强度和良好的粘附性,可提供可靠的黏结效果,还具有良好的电绝缘性能,防止芯片与基板之间短路。
-
-
双边引脚
-
双列直插式引脚封装(Dual Inline Packages,DIP):常见的封装结构形式,有多层陶瓷双列直插式、单层陶瓷双列直插式、引线框架式等。
-
小型化封装(Small Outline Packages,SOP):包括 SOJ(J 型引脚小外形封装)、TSOP(薄小外形封装)、VSOP(甚小外形封装)、SSOP(缩小型 SOP)、TSSOP(薄的缩小型 SOP)及 SOT(小外形晶体管)、SOIC(小外形集成电路)等,引脚间距和脚数多样。
-
-
四边引脚
-
四边扁平封装(Quad Flat Pack,QFP):操作方便、可靠性高,封装外形尺寸较小,寄生参数减小,适合高频应用,主要适合用 SMT 表面安装技术在 PCB 上安装布线,但引脚中心距小于 0.65mm 时引脚容易弯曲,有改进品如 BQFP、GQFP、TPQFP 等。
-
针格式封装(Pin Grid Array,PGA):插拔操作方便、可靠性高,可适应更高频率,安装时将芯片插入专门的 PGA 插座,如 CPU 等芯片常用此封装,其引脚数可发展到较高数量。
-
-
底部引脚:如 BGA 封装,底部是球形引脚,直接焊接在 PCB 板上,具有一些独特的性能和应用特点。
五、IC 元件标准化定义(四)
(一)DIP 的其他变形体
-
SDIP:更宽、更平、更长的 DIP 芯片,长边上包含大量引脚,脚中心距小于 DIP。
-
SKDIP:一种标准 DIP,引脚间距为 0.1 英寸(2.54 毫米),行间距为 0.3 英寸(7.62 毫米)。
(二)在热处理规划上加入散热片设计的封装
-
TSOP:成品成细条状,长宽比约为 2 比 1,适合用表面贴装 SMT 技术,适合高频应用,操作方便,可靠性高。
-
UTSOP:类似 TSOP,在某些方面有所改进或优化(具体改进内容未详细提及,可能与尺寸、性能等相关)。
-
TQFP:能有效利用空间,适合对空间要求较高的应用。
-
DHS - QFP:与传统 QFP 相比,铝制嵌入式散热器的热性能提高了 17%,适用于 2 - 3 瓦功率应用。
-
DPH - QFP:具有特定的结构设计(具体结构特点未详细提及,可能与散热、封装强度等相关),以适应不同的应用需求。
(三)芯片型封装(CSP)与 DCA 封装
-
CSP:封装成型后的芯片是原来裸晶的 1.2 倍,具有体积小、输入和输出端数多、电性能好、热性能好、重量轻、气密性好等特点,适用于表面安装。
-
DCA(Direct Chip Attach)封装:直接芯片连接,是将封装好的芯片直接放置在基板或印刷电路板上的组装技术,Chip - on - Board(CoB)和 Chip on Flex(CoF)都属于 DCA 技术。
(四)LOC 封装
-
舍弃传统芯片黏结方式,以聚亚酰胺(Polyimide,PI)树脂胶带将 IC 芯片接合于引脚架之下,具有电性能优越、小型化和高集成度、散热性能优越、降低电磁干扰等优点,但制造和封装难度较大,受限于引线数目,对芯片设计要求高。
(五)PGA 与 BGA 的区别
-
应用上:BGA 通常用于薄笔记本主板(如 X 系列笔记本);PGA 是一种较老的芯片封装,比 BGA 大,一般用于台式机(一般 T 系列,CPU 可以随时交换)。
-
引脚外形上:BGA 底部是球形的,一般直接焊接在 PCB 板上,拆卸焊接需要专用的 BGA 修复台,个人不能拆装焊接;PGA 的销钉是针状的,安装时可以将 PGA 插入专用的 PGA 插座中,便于拆卸。
-
成本上:BGA 是在 PGA 的基础上发展起来的,BGA 技术更先进,焊接比 PGA 更简单,而且价格比 PGA 便宜,PGA 是较旧的封装方法,焊接更麻烦且更昂贵,BGA 的性价比远高于 PGA。
六、插装 IC 介绍
(一)DIP(Dual In - line Package)
-
封装结构:包括 Bonding Wire(金线)、Die(晶片)、晶片托盘、Resin mould(树脂模封)、Leadframe(引线框架)等,内引脚用于连接芯片和外引脚,外引脚用于与电路板连接。
-
材料类型
-
塑胶封装 DIP:大部分使用热固性树脂塑胶,固化周期短,可大量生产。
-
陶瓷封装 DIP:气密性良好,常用于高可靠度设备。
-
-
引脚间距与数量:一排引脚之间的间距为 2.54 毫米,二排引脚之间的距离常见为 7.62 毫米或 15.24 毫米,引脚数恒为偶数。行间距为 0.3 英寸时,常见引脚数为 8 至 24,偶尔有 4 或 28;行间距为 0.6 英寸时,常见引脚数为 24、28、32 或 40,也有 36、48 或 52 等。插拔时需小心以免损坏管脚。
(二)SIP(Single Inline Packages)
-
常见封装外形与引脚特点:目前常见有 SIP8、SIP9 和 SIP10 等,数字表示引脚数目,引脚数量通常在 2 - 23 之间,引脚节距为 2.54mm 或 1.27mm。
-
应用举例:如电源芯片、变压器、电阻电容等,外壳灌封而成,通常采用 SIP4 封装。在先进封装工艺中,SiP(System - in - a package)指系统级封装,将多个不同功能的有源电子元件与无源器件优先组装在一起,实现一定功能的单个标准封装件,形成系统或子系统,具有高度集成、优化功耗、高性能低延迟、功能丰富、减少封装尺寸等优点。
(三)PGA(Pin Grid Array)
-
应用领域与引脚发展:大多应用于高脚数、高功率及高效能的计算机上,引脚数可发展到 68 - 256 只脚。

(四)BGA、PGA、LGA 对比
-
应用场景差异:BGA 常用于注重功耗的 CPU 封装(如笔记本电脑);PGA 一般用于台式机,方便更换 CPU;LGA 几乎被所有高端性能 CPU 采用(如英特尔酷睿系列)。
-
面积比较:BGA < PGA < LGA。
七、贴装 IC 介绍
(一)SOP(Small Outline Package)
-
引脚特性与类型:引脚间距有 1.27、1.0、0.8mm 三种,脚数为 8 - 48 只。常见类型包括 MSOP(迷你型 SOP)、TSOP(薄型 SOP,厚度小于 1.27mm)、SSOP(缩小型 SOP,引脚间距小于 1.27mm)、TSSOP(薄缩小型 SOP)、HTSSOP(带散热器的 SOP)、QSOP(1/4 大小的 SOP)、VSOP(超微型 SOP,比 QSOP 更小)。
-

(二)SOJ(Small Outline J - Lead)
-
主要应用与引脚形状:主要用作 DRAM(动态随机存取内存),标准脚距为 1.27 毫米,脚数为 20 - 44 只,引脚形状为 J 型。
(三)PLCC(Plastic Leaded Chip Carrier)
-
封装特点
-
引脚布局:布线方便,易于连接其他电路。
-
引脚形状:插入或焊接到封装底座或基板时更稳固。
-
芯片保护:具有较好的绝缘性和抗震性能。
-
可编程性:部分支持可编程功能,脚数最大上限为 84 只。
-
(四)QFP(Quad Flat Package)
-
引脚参数与共面性标准:引脚数为 44 - 304 只,QFP 共面性标准为 ±0.1mm,即引脚顶端所在平面与基准平面的偏差不超过 ±0.1mm,以确保良好的焊接和电气连接性能。

八、BGA&FC 介绍
(一)BGA(Ball Grid Array)
-
基本结构与特点:使用基板和锡球取代传统导线架,提供微细间距优点。根据基板不同分为 TBGA(Tape BGA)、FCBGA(Filp chip BGA)、PBGA(Plastic BGA)等类型。
-
PBGA 特点
-
优点:制作成本低,性价比高;焊球参与再流焊点形成,共面度要求宽松;与环氧树脂基板热匹配性好,装配至 PCB 时质量高、性能好。
-
缺点:对潮气敏感,爆米花效应(PoPCorn effect)严重,可靠性存在隐患。爆米花效应是指敏感器件受潮后经高温热处理,内部潮气气化导致器件膨胀,造成封装材质与晶片之间脱层分离等问题。
-
-
CBGA 特点:金属盖板用密封焊料焊接在基板上保护芯片等,对湿气不敏感,可靠性好,电、热性能优良,与陶瓷基板 CTE(热膨胀系数)匹配性好,连接芯片和元件可返修性较好,裸芯片采用 FCB 技术互连密度更高,但封装成本较高,与环氧树脂等基板 CTE 匹配性差。
-
FCBGA 特点:结合了覆晶接合(Flip Chip)技术和普通 BGA 底部焊球技术,是目前图形加速芯片主要封装格式,具有优异电性效能,可减少组件互连损耗及电感,降低电磁干扰,提高 I/O 密度和使用效率,有效缩小基板面积,散热性好,可提高芯片高速运行稳定性。
-
TBGA 特点:又称阵列载带自动键合,是较新颖的 BGA 封装形式,与环氧树脂 PCB 基板热匹配性好,是最薄型 BGA 封装形式,有利于芯片薄型化,成本较 CBGA 低,但对热度和湿度较为敏感,芯片轻且小,自校准偏差大。
(二)FC(Flip Chip)
-
接合结构与流程:在晶粒金属垫上生成焊料凸块,于基版上生成对应接点,将翻转的晶粒对准接点接合。属于平列式接合,其精髓在于控制接点高度(C4 接合)。工艺流程包括在晶圆上刻划集成电路、芯片表面金属化、在垫上沉积焊接点、切割芯片、芯片翻转和定位、重熔焊球(通常用热风回流焊)、在安装的芯片底部填充电气与绝缘胶。
-
凸点下金属化层(UBM)作用:防止封装中的金属及污染离子向芯片表面金属层扩散,避免造成腐蚀或形成硬脆的金属间化合物(IMC),从而降低互连系统的可靠性。UBM 包括抗氧化层、粘接层、阻挡层、润湿层等结构。

DAMO开发者矩阵,由阿里巴巴达摩院和中国互联网协会联合发起,致力于探讨最前沿的技术趋势与应用成果,搭建高质量的交流与分享平台,推动技术创新与产业应用链接,围绕“人工智能与新型计算”构建开放共享的开发者生态。
更多推荐
 已为社区贡献1条内容
已为社区贡献1条内容
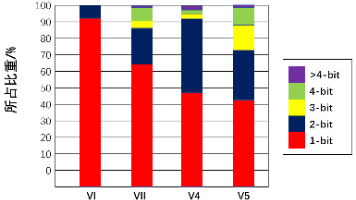







所有评论(0)